(F-2): ダイシングプロセス
ダイシングによってSiCのウエハーを切断してチップにすると、切断部分に高密度のショックレー型積層欠陥とその積層欠陥の縁に多数のSiコア部分転位が導入されます。トランジスタがOFFの時にMOSFETのp型層から伸びる空乏層が切断面に達すると、切断面の欠陥を介してリーク電流が流れてしまいます。それを防ぐために、MOSFETとして動作する活性領域と切断端面の間には、周辺耐圧構造が配置されて空乏層の広がりをコントロールしています。この周辺耐圧構造は数十ミクロンほどの幅があり、ダイシング時に導入された高密度のショックレー型積層欠陥とSiコア部分転位が、周辺耐圧構造を超えてMOSFET活性部の、n–ドリフト層に側面から侵入する可能性はかなり低いと思われます。しかしながらREDG効果を起こす可能性があるものはこの連載では考察しているので、側面からn–ドリフト層にSiコア部分転位や積層欠陥が侵入した場合を想定して、どのような形状の積層欠陥が成長するのかを考察してみます。
図11-8(a)上段はMOSFETの[1100]方向の端、つまりMOSFETの右端にb=1/3[0110]のSiコア基底面部分転位とショックレー型積層欠陥が導入された例です。下段の図はREDG効果によって積層欠陥が成長した状態です。図11-8(b)はMOSFET右端にb=1/3[1010]のSiコア基底面部分転位とショックレー型積層欠陥が導入されREDG効果によって積層欠陥が成長した状態です。図11-8(c)はMOSFET右端にb=1/3[1100] のSiコア基底面部分転位とショックレー型積層欠陥が導入された例です。図11-8(d)はb=1/3[1100] のSiコア基底面部分転位とショックレー型積層欠陥がMOSFET左端に導入された例です。図11-8(a),(b)の場合はREDG効果によって三角形状の積層欠陥が成長した後、成長は停止しますが、図11-8(c),(d)の場合は積層欠陥の成長は、片側の端に到達するまで継続します
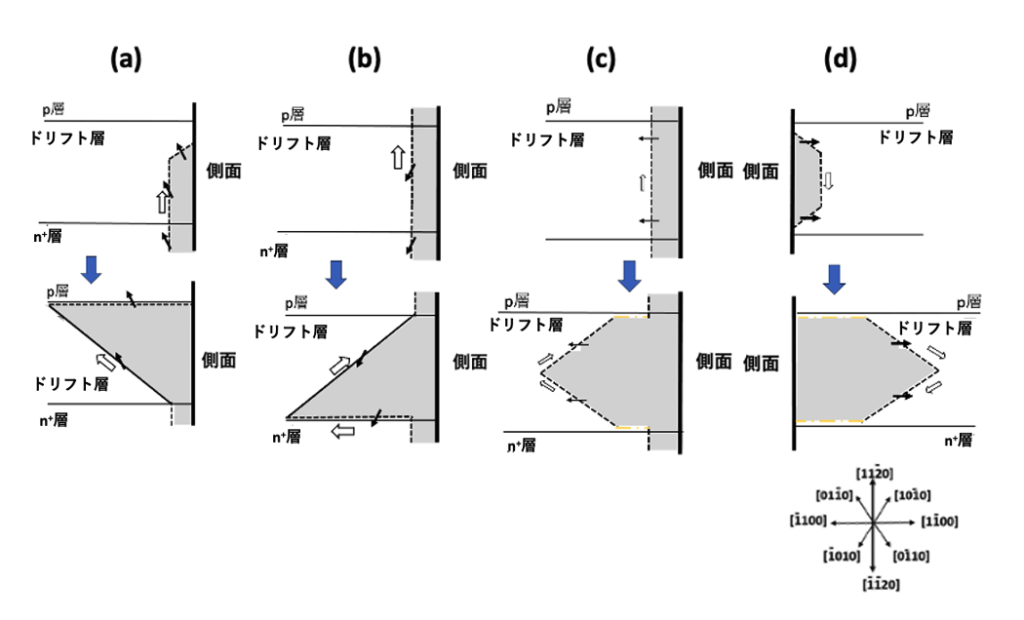
図11-8では、図11-8(a), (b)で観察されるように直角三角形の形状の積層欠陥を形成して積層欠陥の成長が停止してしまう場合と、図11-8(c), (d)で示されているように、MOSFETの片側の端面で発生した積層欠陥はそのまま成長を続け、遮るものがなければ、もう一方の端面に到達するまで成長を続ける場合の、2種類の場合があるということを示しています。
まとめ
この回では、n–ドリフト層の上側から侵入してくる基底面転位や積層欠陥や、n–ドリフト層の側面から侵入してくる基底面転位や積層欠陥が、どのような形状の積層欠陥を形成するのかを考察しました。n–ドリフト層の上側から欠陥が張り出した場合と、n–ドリフト層の下側から基底面転位が侵入した場合に形成される積層欠陥の形状が異なっており、ちょうど(1120)面を鏡とした上下が反転した形のものが現れています。この結論は、利用価値のある結論だと思われます。
また、n–ドリフト層の側面から侵入してくる基底面転位や積層欠陥の場合、REDG効果によってどのような形状の積層欠陥が成長するのかについ考察しました。この場合の形状も、他の原因による積層欠陥の形状とは異なる形状の積層欠陥が成長することがわかります。







コメントを残す