(D-2) g: 複数の異なるバーガース・ベクトルを持つ貫通刃状転位とL字状界面転位の交差
エピ層成長の際の界面転位の活動時には、L字状界面転位は複数の異なるバーガース・ベクトルを持つ貫通刃状転位の林を動いてそれぞれと交差することは想定されます。異なるバーガース・ベクトルを持つ貫通刃状転位との交差では、さらに異なる変位ベクトルを持つ複数の積層欠陥の複雑なドメイン構造の形成が、推察されます。その場合でも、今回の考察と同様に考えれば、推察することは可能です。
図10-8(a)は四面体A’またはC’層のすべり面でL字状の界面転位と、aの位置でb=1/3[1210], bの位置でb=1/3[2110]の 貫通刃状転位と交差し、その後REDGで積層欠陥が成長した状態を例として示しています。この図では界面転位の表面終端部がU字状の転位をばら撒いた状態を想定しています。図10-8(b)は, cの位置でb=1/3[2110]の 貫通刃状転位、dの位置でb=1/3[1120]の貫通刃状転位、eの位置でb=1/3[1210]の貫通刃状転位と交差した場合の積層欠陥の成長状態を示しています。全体の積層欠陥の形状はいびつな形状になり、積層欠陥のドメイン境界が複数観察されます。
他の複数の異なるバーガース・ベクトルの貫通刃状転位の場合や、貫通刃状転位の分布もさまざまな位置に存在している場合も考えられます。それらの積層欠陥のドメインについての考察を記述していくと、話が発散していくので、ここでは、図10-8の2例を示しています。複雑な形状の積層欠陥と、複数の異なる積層欠陥のドメイン構造が形成されますということを結論としておきます。
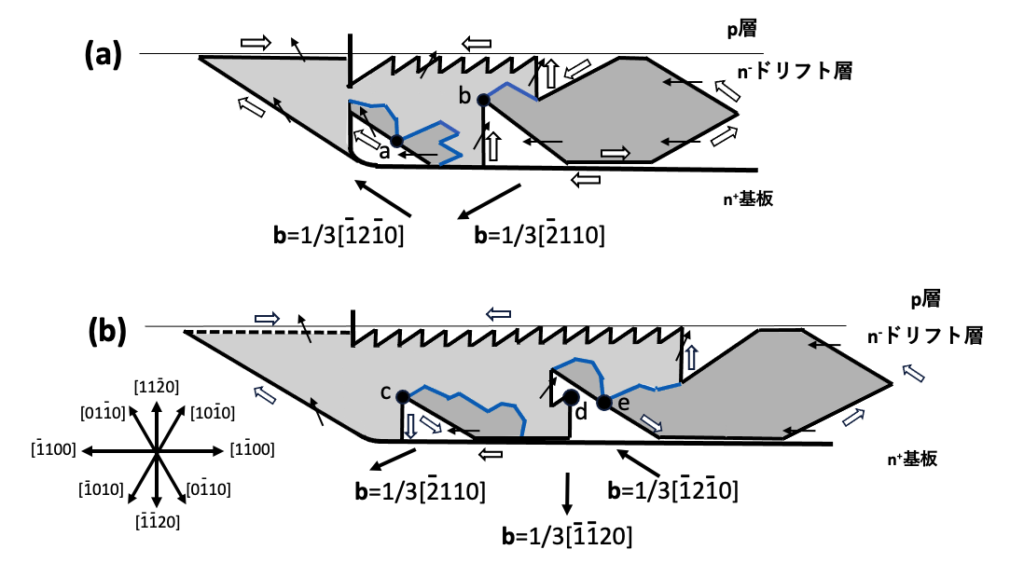
(D-2) h: b=1/3[1120]やb=1/3[1120]の貫通刃状転位と逆L字状界面転位の交差
逆L字状界面転位と貫通刃状転位との交差は四面体A層またはB層中のすべり面上で発生します。これらの四面体A層またはB層中のすべり面上での交差で発生する積層欠陥について考察します。それらの構造は、上で考察した四面体A’層C’層中に存在するL字状の界面転位と貫通刃状転位との交差の場合と、定性的には映進対称な関係です。
図10-9 (a),(b)はb=1/3[1120]の貫通刃状転位と逆L字状界面転位との交差し、さらに後にREDG効果により積層欠陥が成長した状態を示します。(a)はU字状転位がない場合、(b) はU字状転位が生成された場合を示します。図10-9 (c),(d)は基底面転位b=1/3[1120]の張り出し方向が図10-9 (a),(b)とは逆方向の場合を示しています。また、b=1/3[1120]の貫通刃状転位と逆L字状界面転位との交差した場合、貫通刃状転位の周囲に時計回りのb=1/3[1120]の基底面転位リングが形成されることを想定すると、図10-9 (a),(b)と同様な形状の積層欠陥が成長すると考えられます。
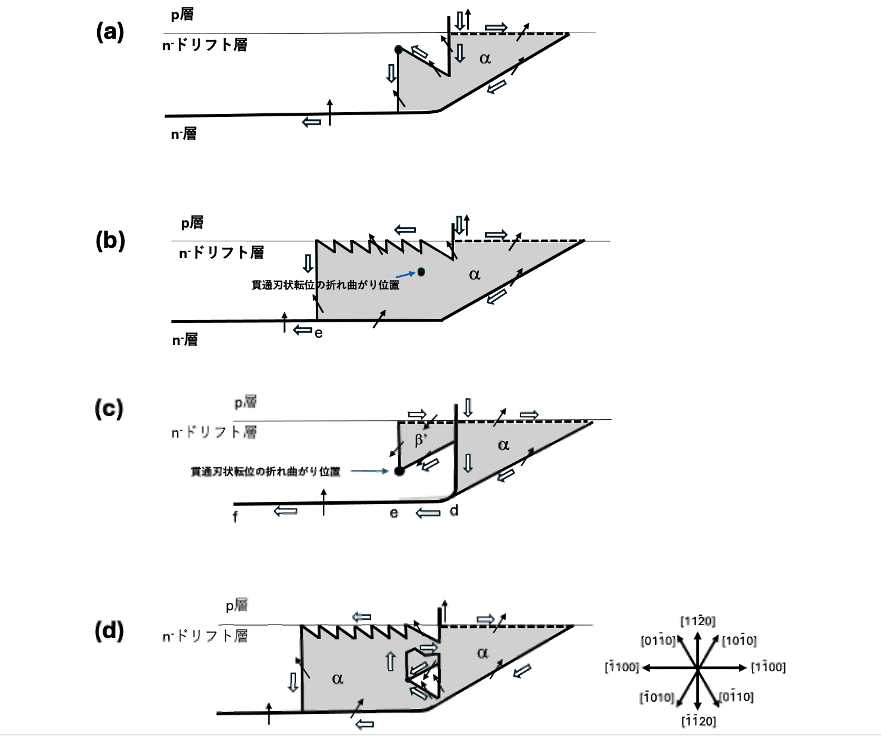
(D-2) i: b=1/3[1210]やb=1/3[2110]の貫通刃状転位と逆L字状界面転位の交差
図10-10(a),(b)はb=1/3[1210]の貫通刃状転位と逆L字状界面転位の交差が原因となって成長した積層欠陥の形態と構造を示しています。これらの形状は、図10-4(b),(d)と映進対称な構造をしています。図10-10(c),(d)はb=1/3[2110]の貫通刃状転位と逆L字状界面転位の交差が原因となって成長した積層欠陥の形状を示しています。これらの形状は、図10-4(b),(d)とc映進対称な形態と構造をしています。
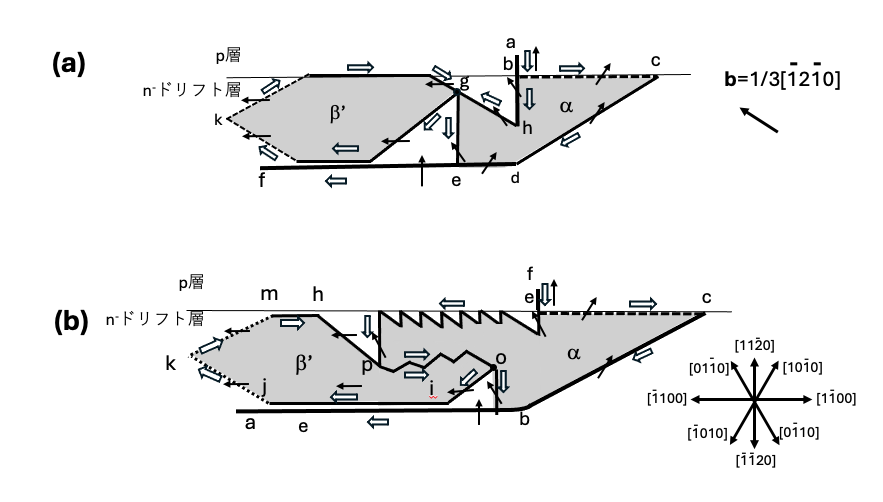

図10-10で示された積層欠陥の形状は、それぞれの貫通刃状転位と逆L字状界面転位との相対的な位置に依存しています。相対的な位置が変われば形状はまた異なってきます。
他の貫通刃状転位と逆L字状界面転位との場合は、L字状界面転位との交差の場合の結果を映進操作によって、同様に描くことができますので省略します。
まとめ
界面転位と貫通刃状転位の交差が原因となって生成する積層欠陥について考察しました。色々な形状の積層欠陥が考察した結論として示されました。界面転位と貫通刃状転位との相対的な位置関係によって、積層欠陥の形状が変化することは容易に推察されると思います。そして積層欠陥の形状はいびつな形状をしています。他にも色々な形状のバリエーションがあることは推察されます。積層欠陥の内部にはドメイン境界が形成されたりします。
界面転位と貫通刃状転位の交差によって出現する基底面転位の場合、基底面転位はとても短いので、この部分からREDG効果によって積層欠陥が大きく成長するには、他の場合に比べて長い時間が必要と考えられます。U字状転位がない場合、この交差が原因のMOSFETの特性劣化は遅延して現れるかもしれません。交差によって出現した基底面転位が、後のデバイスプロセスで、応力を受けて基底面転位が長く大きく張り出す場合は、効率よく積層欠陥が成長します。
エピ層成長プロセス後のデバイスプロセスで、ウエハが応力を受けることがなく、基底面転位は張り出さず、短いままの状態で、さらにU字状転位が存在する場合を想定すると、U字状転位から成長する積層欠陥の方が速く大きな面積を占めると考えられます。交差が原因による積層欠陥は成長が遅いので、交差が原因の積層欠陥の成長の余地はもはや無く、積層欠陥のドメイン構造は見え無くなることも考えられます。
これらの複雑な積層欠陥構造の出現を抑えるためには、界面転位の形成を抑制させることです。連載の(9)でも述べましたが、界面転位の抑制は昇温、降温、高温プロセスの際のウエハの温度分布を均一にすることだと考えられます。
次回の連載(11)ではMOSFETのn–ドリフト層の上側、つまり[0001]側からn–ドリフト層へ短い基底面転位が侵入した場合や、n–ドリフト層の側面から基底面転位が侵入した場合について考察します。REDG効果によってどのような形状の積層欠陥が成長するのかを考えます。







コメントを残す