次に、貫通らせん転位や貫通混合転位と基底面らせん転位との交差を考えてみます。図7-2 (b)では、基底面らせん転位にとって貫通らせん転位や貫通混合転位は通り過ぎるのに苦労するけれど、最終的には交差して通り過ぎる事は書きました。交差後には何が発生しているのかを考察します。
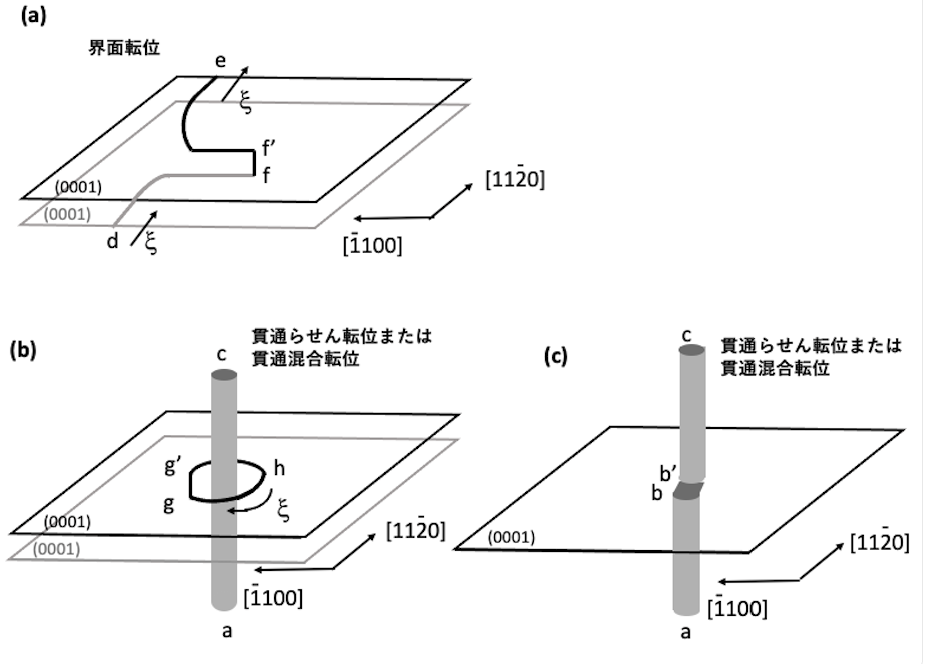
図7-4(a) は界面転位の基底面らせん転位部deが、貫通らせん転位と交差し通過した直後の界面転位の基底面らせん転位部の形状です。df部は基底面転位、f’e部も基底面転位部、ff’は貫通刃状転位部。df部、f’e部は界面転位として[1100]方向へ移動していきますが、ff’部の貫通刃状転位部はピンどめされています。この貫通刃状転位部部分は空孔を吸ったり吐いたりして移動することは可能です。ff’部の長さは1cの長さつまりユニットセル長です。この長さは短いので、多量の空孔の拡散を必要とせずに、短いff’部はエピ層表面へ短時間で抜けて行き消失すると考えられます。「比較的短時間に“まがり”のない基底面らせん転位に戻ることが推察されます」、と都合よく解釈することにします。そうすると再び界面転位の基底面らせん転位部は運動を開始することができます。
図7-4(b)は交差後の貫通らせん転位または貫通混合転位acの状態です。考えられる状態“その1”を示しています。基底面らせん転位は、貫通転位acを切ることができず貫通転位acの周囲に転位ループを残して去って行った状態です。転位ループの向きを時計回方向に設定し直すと、転位g’hgの部分はb=1/3[1120]の転位です。gg’部はb=1/3[1120]の貫通刃状転位部です。この貫通刃状転位部分の長さは1cです。このb=1/3[1120]の転位ループはそのまま貫通転位acの周りにまとわりついた状態で残存すると考えられます。図7-4(a)ではf’ がfよりも[0001]方向側、図7-4(b)ではg’ がgよりも[0001]方向側に描いています。これは貫通らせん転位の符号に依存しています。
図7-4(c)は交差後の貫通転位acの考えられる状態“その2”を示しています。基底面らせん転位は、貫通転位acを切ってしまった状態です。貫通転位acに“まがり”bb’が生じています。bb’部はフランクの部分転位のみの場合とショックレーの部分転位を含む場合に分解しているかもしれません。“まがり”の長さは基底面転位のバーガース・ベクトルの長さです。状態“その1”と状態“その2”のどちらが発生するかは、それぞれの転位の周囲の結晶格子の歪みエネルギーの大小によって決まってくると考えられます。単純に考えると、状態“その2”は発生しないのではと推察します。
以上が、n–ドリフト層内部で発生する基底面転位についての考察でした。これらは、推察による話を書いています。次に、n–ドリフト層の上側からn–ドリフト層へ入ってくる基底面部分転位、基底面完全転位について考察します。
(E) n–ドリフト層の上部から導入される格子欠陥
p層はイオン注入と活性化アニールによって形成されることになっています。Siデバイスの場合はイオン注入後の活性化アニールにより多数のフランク型積層欠陥が形成され、さらに複雑なプロセスを経て、アニール最終段階でそれらの格子欠陥は消失していくことは知られています。4H-SiCの場合、イオン注入と活性化アニールによりどのような格子反応が起こっているのかは詳しくは調べられていないと思います。4H-SiCの場合にもイオン注入と活性化アニールによりフランク型積層欠陥が発生し、それらがアニールにより消失することなどが考えられます。ここでは、完全には消失していない場合を想定して考察します。4H-SiCのフランク型積層欠陥の変位ベクトルは±c軸方ですが、フランク型積層欠陥のふちに存在するフランク型部分転位の周りには局所的に複雑な格子歪を伴っています。周囲に基底面転位やショックレー型積層欠陥が生成する可能性もあります。また、4H-SiCのフランク型積層欠陥には、ショックレー型積層欠陥成分が伴っているものも存在しています。それらの格子欠陥がn–ドリフト層との界面に直接に接するように存在する可能性も考えられます。そのような格子欠陥がn–ドリフト層へのショックレー型積層欠陥や基底面転位の供給源になる可能性も考えられます。
また、ゲート酸化膜形成時に酸化膜界面からn–ドリフト層への基底面転位の張り出しも可能性はあります。筆者は15年ほど前に、TEMで4H-SiCの酸化膜との界面の断面と平面の観察を行ない、国際会議で発表しています。[Matsuhata et al., Mat. Science Forum Vol. 600-603, 671 (2009)] 平面の観察では、アモルファスSiO2/4H-SiC界面が平坦ではなく、何らかの理由により、局所的に4H-SiC側に小さな窪みが発生している場所が観察されたりします。これらの窪み部分から基底面転位が生成し転位組織が形成されている場合があり、この局所的な窪みはそれなりの頻度で存在したりしています。酸化条件を変えて系統的には調べてはいないので、この現象は酸化膜構造形成条件に依存しているのかそうでないのかは不明です。これらの界面から生成した基底面転位がn–ドリフト層へ張り出せば、順方向特性劣化の原因になると考えられます。トレンチ構造の場合は基底面転位はn–ドリフト層の側面方向からも侵入してくる可能性はあります。
またワイヤーボンディングプロセスではある程度の圧力がMOSFETに加わります。コンタクト部分からSiコア部分転位と積層欠陥が生成され上側からn–ドリフト層へ転位が侵入することは可能性としては推察されます。
以上のp層形成工程、酸化膜形成工程、ワイヤーボンディング工程ではp層側、あるいは酸化膜側からn–ドリフト層への基底面転位の導入についての考察しました。
(F) その他のプロセス、n–ドリフト層の側面から入ってくる基底面転位。
10年以上前のプロジェクトで、筆者はある程度の個数のダイシングされた4H-SiCチップを放射光X線トポグラフ法で観察しています。ダイシングされたチップの側面には、たくさんのSiコア部分転位やショックレー型積層欠陥が導入されていることは、当時はしばしば観察しています。同じダイシング加工でも、基底面転位を多量に導入してしまうダイシングがあるようです。また、MOSFETの側面は側面処理がなされているので、ダイシングで導入された格子欠陥は側面処理部までは侵入していると考えられます。側面処理部分を突き抜けて、側面からSiコア部分転位がn–ドリフト層部分に侵入してくる可能性はとても低いと考えられますが、側面からSiコア部分転位がn–ドリフト層部分に侵入する場合どうなるかを例として考察します。このMOSFETの側面とは(1100)または(1100)面のことです。
またトレンチMOSで、SiO2/SiC界面が(1100)または(1100)面に設定されていて、これらの界面から4H-SiC側に基底面転位が張り出している場合は、ダイシングで導入された格子欠陥の例と同じように議論することができると考えられます。
まとめ
連載の(6),(7)ではSiC-MOSFETのn–ドリフト層の下側、上側、側面から侵入する基底面転位はどのようなものがあるかを考察しました。またn–ドリフト層中に残存する界面転位や界面転位に関連して残存する基底面転位について整理しました。また、貫通転位の折れ曲がりによるn–ドリフト層中での基底面転位の出現などを考察しました。
それらの基底面転位は
(A) 基板中の基底面転位が、貫通刃状転位に変換する前にn–ドリフト層部にわずかに侵入する基底面転位。
(B) n–ドリフト層部中に存在するb=1/3[1120]のL字または逆L字状の界面転位。
(C) n–ドリフト層部中にばら撒かれるU字状のb=1/3[1120]の多量の微小転位。
(D) n–ドリフト層部中に発生する基底面転位。
D-1. 貫通刃状転位の折れ曲がり。
D-2. 界面転位と貫通転位の交差によって発生する短い基底面転位。
(E) n–ドリフト層上部から張り出す基底面転位。
p層形成プロセス。 酸化膜形成プロセス。ワイアーボンディングなどのデバイス実装プロセスなど。
(F) その他。n–ドリフト層の側面からの基底面転位の侵入。ダイシング工程時にデバイス側面からn–ドリフト層へ侵入する基底面部分転位。またはトレンチMOS構造の(1100)または(1100)面のSiO2/SiC界面から基底面転位が生成した場合。
10年以上前のプロジェクトでの筆者による観察では、基底面転位組織(A),(B),(C)が圧倒的に積層欠陥成長の原因でした。上記の(D),(E),(F) は推察によるものです。
次の連載(8)以降では、n–ドリフト層内部に導入される基底面転位がどのように、REDG効果を引き起こし、それらがどのような形状のショックレー型積層欠陥を示すのかを順番に考察します。結論を先に述べると、n–ドリフト層に下側から入ってきた基底面転位と、上側から入ってきた基底面転位と、側面から入ってきた基底面転位と、n–ドリフト層内部で発生した基底面転位では、それぞれ形成される積層欠陥の形状が異なるということです。







コメントを残す