はじめに
Siデバイスの場合、元々のSiウエハ中には転位や積層欠陥などの格子欠陥がほとんど存在していないため、それらを気にすることなくデバイスの作製や利用が可能です。4H-SiCデバイスの場合、SiCウエハ中には、ある程度の密度で転位や積層欠陥などが含まれています。これらの欠陥はそのままエピ層に引き継がれます。また、転位が存在していると、それらが増殖源となり、デバイスプロセス中に転位の増殖などを起こします。そして、この連載で考察してきたショックレー型積層欠陥の増殖・成長なども引き起こしたりします。
この一連の連載では、REDG効果によってn–ドリフト層中に存在する基底面転位からどのような形状の積層欠陥がどのように生成するのかを考察してきました。成長した積層欠陥の形状を調べると、積層欠陥の成長を引き起こした基底面転位の素性が推察できます、という話をしました。n–ドリフト層中に導入された基底面転位の素性がわかれば、場合によっては、プロセスの改良で対応することは可能かもしれません。今回は最終回です。それぞれの素性の基底面転位からどのような形状の積層欠陥が生成するのかについて、全体のまとめを行います。
n–ドリフト層中に侵入してくる基底面転位の整理
最初に、この連載では各基底面転位の転位ループの構造を整理しました。同じバーガース・ベクトルを持つ基底面転位でも、基底面転位が位置する四面体層の違いにより、転位ループの構造が異なることを示しました。そして、2種類の異なるすべり面上の異なる6つのバーガース・ベクトルを持つ合計12種類の基底面転位ループの構造を整理しました。これらは連載(1)から連載(3)で解説しています。
30度Siコア基底面部分転位が動くことにより積層欠陥が成長するという実験的報告は多数存在しています。整理した基底面転位の構造と実験で報告されている実験結果との比較では、30度Siコア部分転位のみならず最終的にはすべてのSiコア部分転位からショックレー型積層欠陥が湧き出し、Cコア部分転位からは湧き出さないと考えて議論を進めました。このことは観察結果と一致します。そして、Siコア部分転位でもなくCコア部分転位でもない基底面らせん部分転位は臨界状態だと想定しました。実際の実験では、積層欠陥が成長している場合が観察されたりします。ごくわずかな基底面部分転位の向きの違いにより積層欠陥が成長したりすると考えられます。この前提により整理は楽になりました。この整理に基づき、基底面転位の向きと、そのバーガース・ベクトルとを考慮して湧き出してくる積層欠陥の形態・形状を考察しました。これらは連載(4)から連載(5)で解説しています。
そして、MOSFETのn–ドリフト層部分にはどのような基底面転位が存在するかを、以下のように整理しました。下記の(A),(B),(C)の例は過去に実際に観察されたものを示しています。(D),(E),(F)は、ほぼ推察によるものです。以下に示す基底面転位が積層欠陥成長の原因になっていると考えられます。
(A) 基板中の基底面転位の大部分は、エピ層成長によりn–ドリフト層を作製するときに、貫通刃状転位に変換されますが、その変換前にn–ドリフト層部にわずかに基底面転位は侵入します。つまり、n–ドリフト層部に下側から短い基底面転位が存在しています。これについては連載(6)と連載(8)で説明しています。
(B) n–ドリフト層部中に存在するb=1/3[1120]のL字または逆L字状の界面転位が発生することがあります。これらの界面転位は基底面転位です。これについては連載(6)と連載(9)で説明しています。
(C) 界面転位が活動中にその表面終端部分が多量にU字状転位をばらまくことがあります。U字状転位はn–ドリフト層中に存在しています。U字状転位の底の部分は基底面転位です。これについても連載(6)と連載(9)で説明しています。
(D) n–ドリフト層部中に新たに発生する基底面転位。
・(D-1) n–ドリフト層部中の貫通刃状転位が何らかの原因によりクランク状に折れ曲がりを形成し、短い基底面転位が発生する場合。これについては連載(7)と連載(9)の後半で説明しています。
・(D-2) エピ層成長中に発生する界面転位と貫通転位との交差により短い基底面転位が形成され、後のデバイスプロセスで、何らかの応力がデバイス構造作製部分に負荷され、この短い基底面転位が動き張り出すことにより少し長くなる基底面転位。これについては連載(7)と連載(10)で考察しています。
(E) n–ドリフト層上部からn–ドリフト層部へ侵入する基底面転位。p層形成工程、酸化膜形成工程、ワイアーボンディング工程などのデバイス実装プロセスで導入される基底面転位。これについては連載(7)と連載(10)で考察しています。
(F) 側面からn–ドリフト層へ侵入する基底面転位や積層欠陥。
・(F-1) トレンチ構造のMOSFETで酸化膜/4H-SiC界面が縦方向の場合で、この縦型界面から基底面転位がn–ドリフト層へ侵入する基底面部分転位によるものです。連載(11)で考察しています。
・(F-2) ダイシング工程時にデバイス側面からn–ドリフト層へ侵入する基底面部分転位。これについても連載(7)と連載(11)で考察しています。
これらの基底面転位から、積層欠陥が湧き出した時にどのような形状として現れるかを考察しました。それらを以下にまとめます。
発生原因(A)と(E)の比較
(A)の場合と(E)の場合での成長した積層欠陥の形状を比較します。n–ドリフト層下側から侵入した基底面転位から成長する積層欠陥の形状を図12-1(a),(b),(c),(d),(e)は示しています。これらは原因(A)によって生成した積層欠陥です。黒丸は起点となった短い基底面転位の位置を示しています。
図12-1(a’),(b’),(c’),(d’),(e’) は、原因(E)による積層欠陥です。n–ドリフト層の上側つまりp層部との界面、あるいはMOS界面から成長した基底面転位が少しだけn–ドリフト層へ入り込んだ部分から成長したショックレー型積層欠陥の形状を示しています。
n–ドリフト層の下側から入ってくる基底面転位から成長した積層欠陥、つまり原因(A)による積層欠陥と、n–ドリフト層の上側から入ってくる基底面転位から成長した積層欠陥、つまり原因(E)による積層欠陥とは、(1120)面に対して対称的な形状を示しています。これらの積層欠陥の形状を見ると、n–ドリフト層の下側から入ってきた基底面転位か、上側から入って来きた基底面転位が原因かの区別は簡単につきます。図12-1の図中の三角形状の積層欠陥はこの形状で成長は停止します。図中の五角形状の積層欠陥はこのまま青矢印の方向に成長し、遮るものがなければMOSFET構造の端まで到達し、そこで成長を停止します。
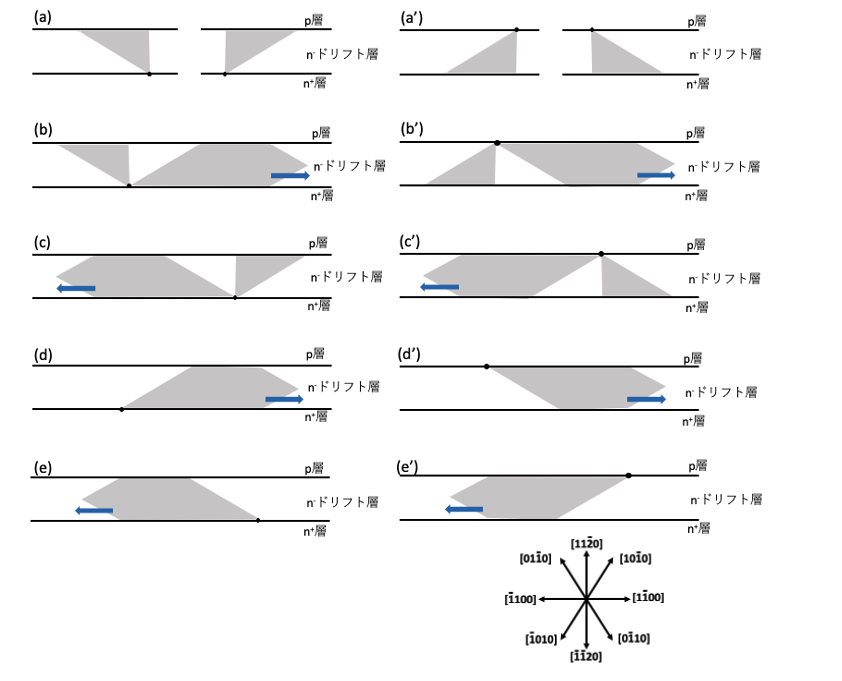
(B)と(C)による積層欠陥
(B),(C)の場合の考察結果をまとめます。界面転位が原因となって成長する積層欠陥の形状を図12-2に示します。L字状界面転位の基底面Cコア刃状転位部分からの積層欠陥の成長はありませんが、L字状界面転位の端の基底面らせん転位部分からは三角形の積層欠陥が成長します。図12-2(a),(b)は三角形の積層欠陥が成長した状態を示しています。つまり原因(B)による積層欠陥です。図12-2(c),(d)は界面転位の端の基底面らせん転位の表面終端部がエピ層成長中にエピ層表面を移動する際にばらまくことがある多数のU字状転位が存在する際に観察される積層欠陥の形状です。つまり原因(B)と(C)による積層欠陥です。これらの積層欠陥の形状は、図12-1で示されている形状とは異なり、原因を区別することができます。
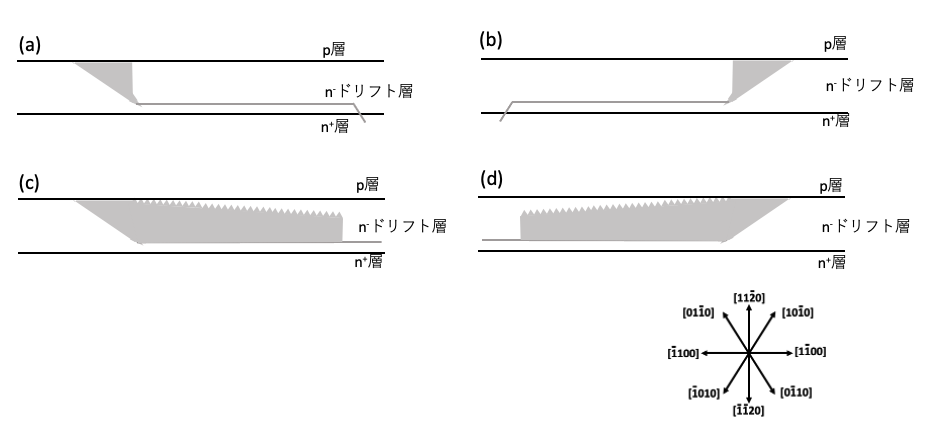







コメントを残す